※PDF版には日本語化された図表が掲載されております。ぜひダウンロードしてご確認ください。
半導体特性評価の課題
エンジニア、研究者は、常に新しい半導体技術、プロセスの開発、または既存技術の改善を求められています。次世代スマートフォンの低電力フロント・エンドの設計、または高効率太陽電池パネルの新素材調査の場合でも、優れた確度、効率で電気測定できる計測器や測定技術が必要になります。
このeガイドでは、半導体測定、特にI-V(電流-電圧)とC-V(容量-電圧)測定に関する一般的な質問に答えます。また、より具体的なアプリケーションの内容にも触れ、難しいアプリケーションで求められる測定をシンプルに実行する方法についても説明します。
一般的な半導体テストの目的
- 半 導体設計エンジニアによる仕様テスト
- デ バイスの電力仕様に対する適合性
- デバイスが全レンジで期待通りに動作することの確認
- どのような条件でもデバイスが危険な動作をしないことの確認
- 素材研究テスト
- サ ンプルの機能低下または不具合の調査
- サンプルの純度の確認
- 素材の均一性のチェック
一般的な半導体テストにおける誤差要因 ※ PDFは全て日本語で説明してあります

微小DC測定誤差はどこで発生し、どのように解決したらよいか?
それぞれの種類の微小信号測定にはさまざまな誤差原因がありますが、ヒントをいくつかご紹介します。
低抵抗測定では、従来の2線式測定では測定結果に不要なリード線抵抗が含まれてしまいます。テスト電流がリード線抵抗を流れることにより、電圧降下は小さくても測定結果に大きく影響するため、電圧計で測定される電圧値はテストする抵抗間の実際の電圧とは異なって大きな誤差になります。ここに示す4線式(ケルビン)接続では、テスト電流はテストする抵抗、ソース・リードに流れ、DUT間の電圧はもう一つのセンス・リードで測定されます。センス・リードを流れる小さな電流は一般的に無視できるため、SMU(ソース・メジャー・ユニット)で測定される電圧は基本的に抵抗間の電圧と一致します。電圧センス・リードは、できる限りテストする抵抗の近くに接続します。
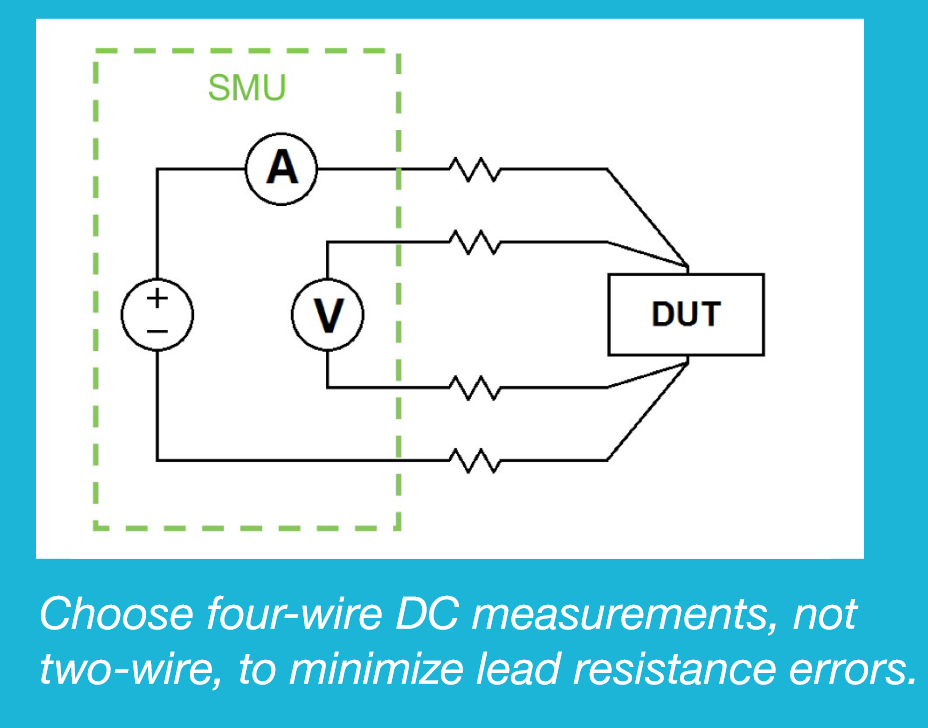

ガードは、ケーブル内のリーク電流を防ぐためにしばしば使用されます。同軸ケーブルのシールドにガード電圧を接続した場合、ガード電圧が30V rmsを超えると安全上の問題が生ずることがあります。トライアキシャル・ケーブルは、大地グランドまたはLOに接続したアウタ・シールドでガード・シールドを覆うことでこの危険性を防ぎます。この構造により、グランド基準でない2つの信号を安全に通し、それと同時に、両方のリードをシールドし、各導体とグランド間の高抵抗を維持することでハイ・インピーダンスのインテグリティを保つことができます。低電流測定でSMUを使用すると、ガード端子によってケーブルとテスト・フィクスチャのリーク電流を抑えることができます。
高い湿度(結露または水分吸収)、イオン汚染(人体の油分、塩分、またはハンダ・フラックス)により、テスト・フィクスチャの絶縁抵抗が大きく低下することがあり、ハイ・インピーダンス測定に大きな影響を及ぼすことがあります。水分は汚れと結びついて電気化学効果を生じ、オフセット電流を生ずることがあります。例えば、エポキシ・プリント回路基板のエッチング溶剤、フラックス、その他の汚れをしっかり落としていないと、導体間に数nAの電流が発生することがあります。このような問題を防ぐためには、耐水性の絶縁材を選び、適度な湿度(理想的には50%以下)に保つ必要があります。テスト・システムのすべてのコンポーネント、テスト・フィクスチャはきれいにし、汚れがないようにします。

非常に小さな電流または大きな抵抗の測定では、機器のケーブルによる小さなノイズであってもS/N(信号対ノイズ)比を悪化させることがあります。この種のノイズを抑えるには、通常は測定システムをDUTに近づけますが、DUTのすぐ隣に計測器を置くことが難しい場合があります。しかし、DUTに近いプローバ内部またはテスト・フィクスチャにプリアンプを取付けると、ノイズ・フロアに埋もれた信号を簡単に取り出すことができます。
4本のプローブまたはケルビン手法により、2本のプローブで電流を流し、もう2本のプローブで電圧を測定します。4本のプローブを使用することで、プローブ抵抗、各プローブの収束抵抗、金属プローブと半導体材料間の接触抵抗による測定誤差を抑えることができます。ハイ・インピーダンスの電圧計では電流はほとんど流れないため、プローブ抵抗、拡がり抵抗、接触抵抗の電圧降下は非常に小さくなります。

帯電された物体が帯電されていない物体に近づくと、静電干渉が発生します。小さな抵抗では帯電は急速になくなるため、通常は干渉の影響は気づかないレベルです。しかし、高抵抗の材料では帯電は急速にはなくならず、不安定な測定になります。一般に、1nA以下の電流測定または1GΩ以上の抵抗測定で静電干渉が問題になります。静電界の影響を抑えるには、測定する回路をシールドで覆います。100GΩ抵抗をシールド測定と非シールド測定で比較した例を示します。非シールドの測定は、シールドされた測定に比べてノイズが大きくなっています。
ACインピーダンス測定誤差はどのように診断し、補正するか?
ACインピーダンス測定問題の原因特定には、さまざまな方法があります。

オープン補償はDUTを外して実行し、主にケーブルまたはテスト・フィクスチャの容量補償のために行われます。ショート補償はDUTの代わりにジャンパを使用して実行し、主にケーブルまたはテスト・フィクスチャのインダクタンス補償のために行われます。ロード補償はメータの全周波数レンジで校正された負荷が必要であり、DUTの代わりにこの負荷で実行し、実際の測定における非直線性またはゲイン・エラーを補償します。

4線式の構成とケーブル補正をしても、ノイズ信号によって重要な測定が正確に行えないことがあります。このノイズは、容量測定ではっきりします。この測定では、ノイズになりやすい小さな電流測定が含まれ、印加と測定が異なった端子で行われるためです。一見穏やかに見えるシステムでも、測定端子の近くにノイズが集中することがあります。ハイとローのリードの位置を切り替えると、すなわち測定する端子を切り替えると、印加と測定を離すことができるため、このノイズを低減またはなくすことができます。
プローバのチャックは非常に大きな容量があり、ランダム・ノイズを集める大きなアンテナになることがあります。基板はノイズの多いプローバのグランドに電気的に接続されるため、電流計はこのノイズに反応して容量測定誤差になります。容量を測定する場合、AC電流計はノイズの少ないデバイス端子に接続します。こうすることで、グランドに対する容量を小さくすることができます。
ノイズの少ないデバイス端子をマニュアルで探し出すことはできますが、新しいシステムにはACソース、DCバイアス、電流計の位置を切り替える機能があり、ケーブルをマニュアルで切り替えたり、プローバのニードルを持ち上げたり、テスト・セットアップを変更することなく、ノイズの少ない端子を探し出すことができます。これにより、AC信号はノイズの最も少ない端子で測定できます。


MOSFETとMOSキャパシタのDC測定誤差を最小にするにはどうしたらよいか?
VDS-ID 掃引、 VGS-ID 掃引、 サブスレッショルド電圧掃引など、一般的に行われているDCテストを実行する
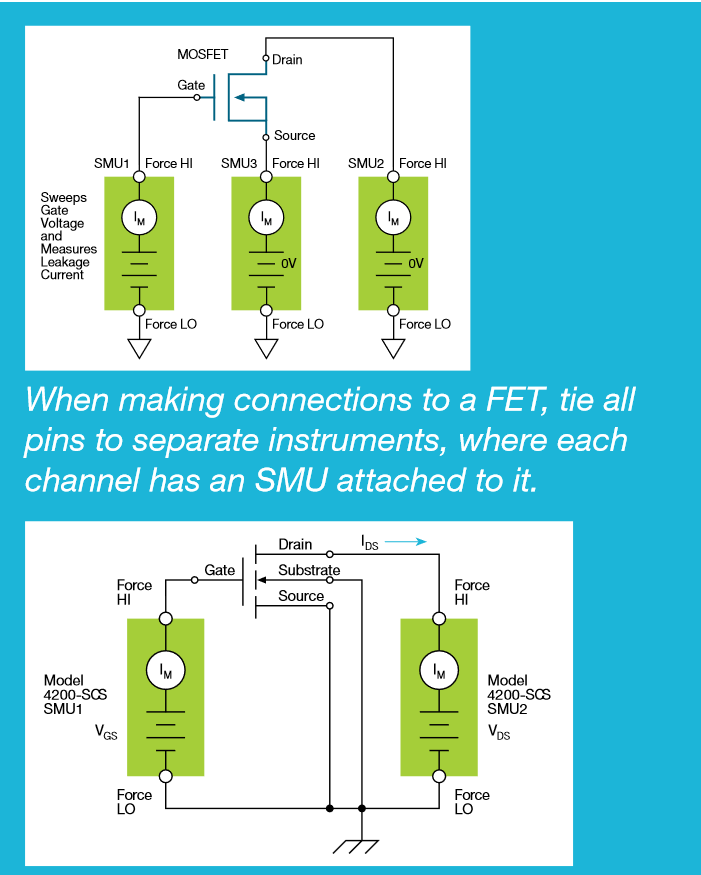
上の図で示す方法では、すべての端子はフィードバック制御された電圧にでき、すべての電流が測定できます。しかし、チャンネルごとにSMUが用意できない場合は、下に示すような接続にします。しかし、この構成ではノイズの多いグランド接続になり、長いケーブルを使用するとグランド・ループができる可能性があります。また、ソース端子では電流と電圧が測定できないため、計算で誤差になることがあります。
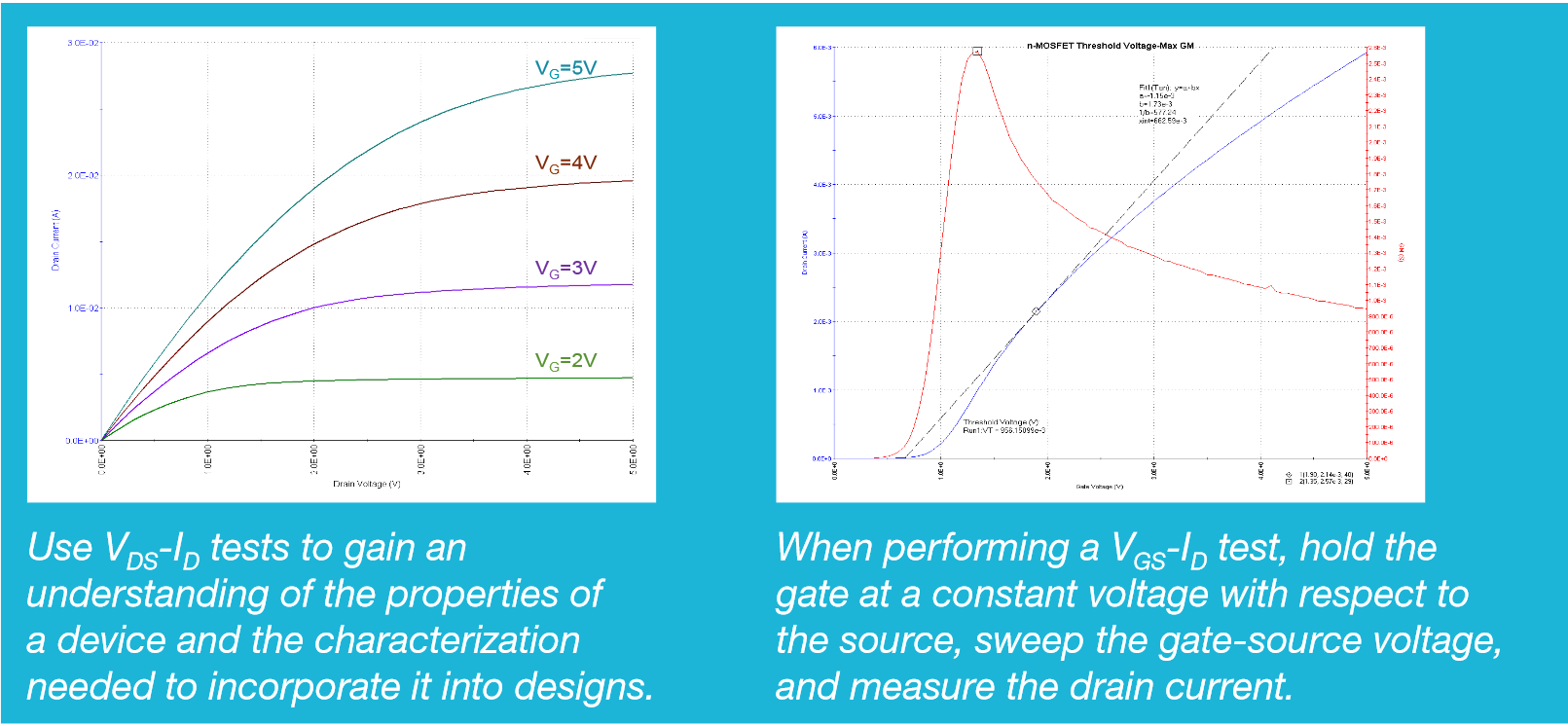
VDS-ID テストでは、ドレイン‒ ソース電圧を掃引してゲート‒ソース電圧を一定にします。このテストにより、MOSFETの特性評価で見慣れた曲線が得られます。ここで示すような曲線を描くには、ゲートを2~5Vまで1Vステップで設定します。ゲート電圧ステップごとに、ドレイン電圧は0~5Vで掃引します。これにより、デバイスの詳細な特性が得られます。
青の曲線は、FETがどのように電圧制御の電流源として使用できるかを示しています。ゲート電圧を変化させ、ドレイン電圧を一定にすることで、重要
な特性評価曲線が得られます。この測定から、曲線の接線を推定し、ゼロ切片を求めてグラフからスレッショルド電圧を求めることもできます。赤の曲線は、トランスコンダクタンス (gm) の計算方法と、トランスコンダクタンスの最大値(Vth)の求め方を示しています。
MOSFETとMOSキャパシタのC-V測定をする場合の最善の方法は?

FETの多くのC-V測定では、ドレイン、ソース、バルクの端子をハンダまたは適切なプローバ接続で一つにする必要があります。まず、C-VメータのCV HI端子をデバイスのゲートに、CV LO端子をデバイスのドレイン/ソース/バルクに接続します。次に、ケーブル補正測定を実行します。まずデバイスを取外し、オープン補正を実行します。ゲートとドレイン/ソース/バルク端子間をジャンパでショートしてショート補正を実行します。最後に、ジャンパの代わりに負荷を入れてロード補正を実行します。最後に、FETを元に戻せば(接続すれば)、正確なC-V測定のためのセットアップは完了です。
シンプルなC-Vスイープの結果からは、MOSデバイスの詳細な情報が得られます。ゲート‒ バルク電圧とゲート容量測定からは、酸化膜厚と不純物濃度がわかります。この値から、標準の並列プレートのキャパシタ式を使ってゲート酸化膜厚が計算でき、別な計算式で不純物濃度とフェルミ準位が計算できます。
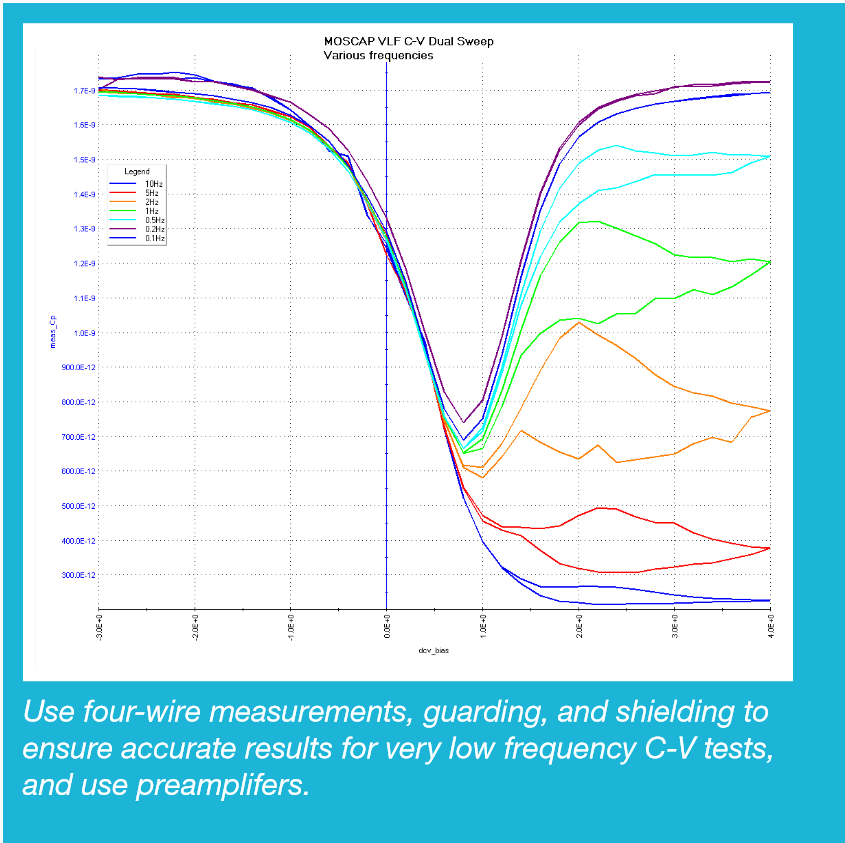
コンデンサの10Hz C-Vスイープは、低周波のデバイス特性が解析できます。一般に、このテストはウエハのMOSキャパシタンス・デバイスのテストで実行されます。テストの最高周波数10Hzで超低電流測定を行うため、SMUを使用します。
プローバの接続をI-V測定からC-V測定に切り替えると、いつも測定で問題が起きる。なぜこんなに複雑なのか?

プローバを使用したウエハでの測定は、一般的にプローバのパッチ・パネル上コネクタを使用する必要がありますが、SMUやC-Vメータのコネクタには合わないことがあります。この場合、測定ごとに異なるアダプタが必要であり、取りづらい場所にあったりします。一般に、テスト設定で再配線する必要がある場合、ケーブルの係数はわずかに変化します。使用する係数を更新するためには再補正を実行する必要があるため、テストに時間がかかり、間違える可能性も高くなります。テストを繰り返し実行する場合、このすべての手順を繰り返す必要があり、以前とまったく同じ係数にすることはできません。
4200A-CVIV型I-V/C-Vマルチスイッチ・モジュールを使用すると、この面倒な作業から解放され、不確かな測定からも解放されます。4200A-SCS型パラメータ・アナライザと併用することで、I-VとC-Vの測定を自動的に切り替えることができます。また、配線切替せずにC-V測定は任意の出力チャンネルに移動できます。この4チャンネル・スイッチは、ウエハのテスト・サイトでプローブ・ニードルを維持できるため、I-V、C-Vの測定で同じインピーダンスを保つことができます。さらに、測定に合わせたテスト・セットアップやケーブルの変更も必要ありません。
4つの出力チャンネルの場合、4200A-CVIV型は最大で4台のSMUを独立してオン/オフできます。また、CV HI端子、CV LO端子、CVUケーブルのアウタ・シールド用の3つの1×4マルチプライヤも装備しています。どのCVUチャンネルも任意、または複数の出力チャンネルに切り替えられます。どのチャンネルもオープンに切り替えることができ、出力はフローティングになります。4つのSMU入力チャンネルは、どのチャンネルもプリアンプ・モジュール(微小電流性能向上のため)、またはパススルー・モジュールをサポートできます。
では、どのように接続する?

4200A-CVIV型の外部接続を示しています。C-V測定は、配線切替せずに任意の出力チャンネルに移動できます。4200-PA型プリアンプまたは4200A-CVIV-SPT型SMUパススルーによる標準の電流分解能を使用することで、各チャンネルは低電流測定用にユーザ設定できます。4200A-CVIV型は、4200A-SCS型メインフレームからUSBケーブルで電源供給されます。
このスイッチはどのように制御する?

4200A-SCS型で実行するClarius™ GUIベースのソフトウェアは、4200-CVIV型マルチスイッチが簡単に制御でき、同じデバイスでI-V、C-V測定が必要なアプリケーションで、迅速かつ効率的なデバイス・テストのワークフロー作成が可能になります。また、Clariusには、CVIVスイッチを設定するためのアクション手順に加えCVIV構成ごとに独自のケーブル補正アクション手順を設定できます。ここに示すシーケンスのような使いやすいプロジェクト・ツリー構造により、アプリケーションで求められるテスト・シーケンスの設定が簡単になります。
4200A-CVIV型の特長
- 同じデバイスのI-V、C-V測定の切り替えが容易
- ケーブルのつなぎ換えが不要
- 補正の再実行が不要
- 異 なった設定での再テストが容易
- ケーブルをつなぎ換えることなく、同じデバイスの複数の端子間のC-V測定が可能
- 時間とケーブルを節約
- 4台までのSMUのスイッチのオン/オフが可能
- 複数のCVHI、CVLOを任意の4つのチャンネルに設定可能
- 任意の端子をオープンにしてフローティング可能
- 任意のチャンネルにCVガード・シールドを接続してノイズを低減
限られた予算ですべての測定を実行するには?
測定性能や確度を妥協せずに複数のテスト要件を対処する、さまざまなテストに対応可能なソリューション
4200A-SCS型パラメータ・アナライザは、9台までのSMUで構成できます。2機種のSMUが利用可能であり、210V/100mAレンジのミディアム・パワーSMUと、210V/1Aレンジのハイ・パワーSMUです。どちらのSMUもメインフレームの1つのスロットにインストールでき、4200A-SCS型システム内で同時に使用できます。4200A-SCS型用のすべてのSMUは低電流/ハイ・インピーダンス測定用にシールドされたトライアキシャル接続とアクティブ・ガード、4線式(ケルビン)のフォースとセンスの接続を装備しています。
4200A-SCS型にオプションで用意されている4210-CVU型マルチ周波数C-Vモジュールは、DUTにDCバイアス電圧を印加してACインピーダンスを、AC電圧を印加してAC電流と位相角を測定します。最大±30Vまたは60V差動のDCバイアス電圧を印加して、1kHz~10MHzのテスト周波数でフェムトファラッド(fF)からマイクロファラッド(μF)までのマルチ周波数の容量測定が行えます。最大で4096ポイント測定でき、C-V(容量‒ 電圧)、C-f(容量‒周波数)、C-t(容量‒ 時間)の測定により、ドーピング・プロファイル、酸化膜厚、キャリア寿命、接合/ピン間/インターコネクト容量を含む、重要なパラメータを抽出することができます。

4200A-CVIV型マルチスイッチは、つなぎ間違いやデバイスを破壊させる可能性があるケーブルの配線切替の必要がなく、同じデバイスでI-VとC-Vの測定が簡単に実行できます。4200A-SCS型とClariousソフトウェアを使用すると、4200A-CVIV型の制御がシンプルに実行でき、C-VとI-Vのテストを1つのプロジェクトに統合してシームレスに連続的に実行できます。
4200A-SCS型にインストールされたSMUにオプションの4200-PA型リモート・プリアンプを接続して使用すると、非常に小さな電流を測定できるようになります。4200-PA型は、任意のSMUに電流レンジを追加することで10aAの分解能が得られます。ユーザにとっては、SMUの測定分解能が上がったように見えます。4200-PA型は、4200-SCS型の後部パネルまたはプローバなどの近くに設置できるため、長いケーブルによる影響をなくすことができます。
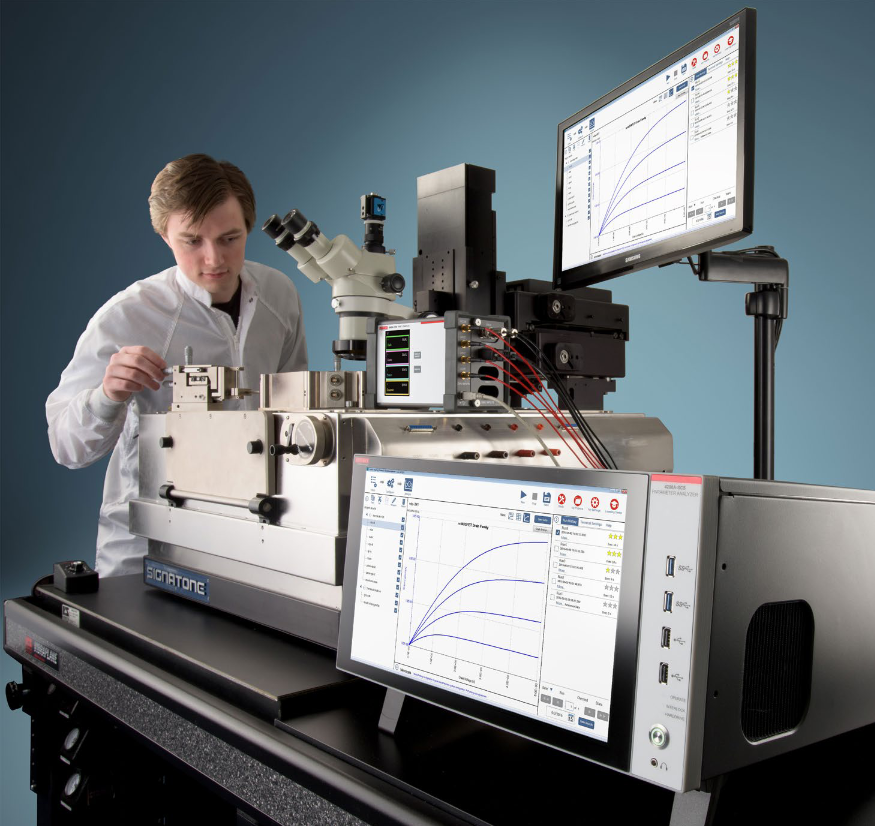
半導体特性評価の課題についての解決方法を調べるには?
豊富に用意されている半導体特性評価に関する資料をご参照ください。
Methods and Techniques for Semiconductor Characterization
Optimizing Low Current Measurements with the 4200A-SCS Parameter Analyzer
van der Pauw and Hall Voltage Measurements with the 4200A-SCS Parameter Analyzer
Resistivity Measurements of Semiconductor Materials Using the 4200A-SCS Parameter Analyzer and a Four-Point Collinear Probe
Techniques For Measuring Resistivity For Materials Characterization
An Ultra-Fast Single Pulse (UFSP) Technique for Channel Effective Mobility Measurement
C‑V Characterization of MOS Capacitors Using the 4200A-SCS Parameter Analyzer
Performing Very Low Frequency Capacitance-Voltage Measurements on High Impedance Devices Using the 4200A-SCS Parameter Analyzer
Using the Ramp Rate Method for Making Quasistatic C-V Measurements with the 4200A-SCS Parameter Analyzer
Using the 4200-CVU-PWR C-V Power Package to Make High Voltage and High Current C-V Measurements with the 4200A-SCS Parameter Analyzer
Switching Between C-V and I-V Measurements Using the 4200A-CVIV Multi-Switch and 4200A-SCS Parameter Analyzer
Make I-V and C-V Measurements 2x Faster 4200a Scs Parameter Analyzer
How to make automatic I-V and C-V measurements
Electrical Characterization of Carbon Nanotube Transitions (CNT FETs) with 4200A-SCS Parameter Analyzer
Electrical Characterization of Photovoltaic Materials and Solar Cells with the 4200A-SCS Parameter Analyzer
4200A-SCS tour
4200A-SCS data sheet
Video: Effortless Parametric Test - 4200 SCS

